IT之家 12 月 17 日消息,据 TheElec,三星电子与三星综合技术院(SAIT)于当地时间 12 月 10 日在旧金山举行的 IEEE 国际电子器件会议(IEDM)上,公开了一项用于实现 10 nm 以下制程 DRAM 的核心技术,相关技术有望应用于 0a 或 0b 世代 DRAM 产品。
相关成果以“用于 10nm 以下 Cell-on-Periphery(CoP)垂直沟道 DRAM 晶体管的高耐热非晶氧化物半导体晶体管”为题发表。
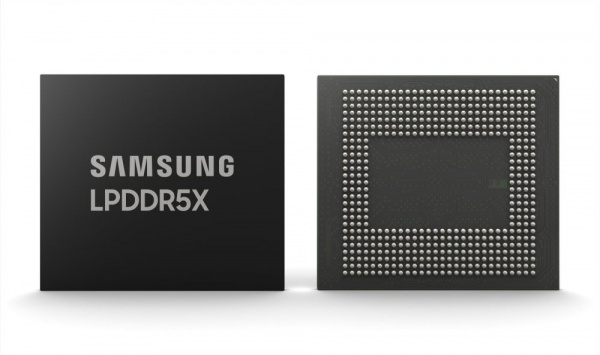
该 DRAM 结构采用 CoP 架构,即将存储单元垂直堆叠在外围电路之上。以往在该结构中,由于在存储单元堆叠工艺过程中会产生约 550 ℃ 的高温,位于下层的外围晶体管容易受损,导致性能下降。
三星电子通过采用非晶态铟镓氧化物(InGaO)材料解决了这一问题。“我们首次演示了可耐受 550 摄氏度高温、沟道长度为 100 纳米的非晶 InGaO 基高耐热垂直沟道晶体管(VCT),并支持将该晶体管集成到单片式(Monolithic)CoP DRAM 架构中。”
沟道是半导体晶体管中电子流动的路径,其长度指源极与漏极电极之间的距离。沟道越短,电子移动距离越小,晶体管开关速度越快,功耗也越低,同时晶体管尺寸得以缩小,从而实现更高的集成度。
三星电子进一步说明:“在 550 摄氏度的氮气热处理(退火)工艺后,器件的阈值电压变化(ΔVt)保持在 0.1 eV 以内,漏极电流几乎没有出现退化。”
IT之家注:阈值电压是决定晶体管开启与关闭状态的最小电压值,只有达到该电压,沟道才会形成。ΔVt 控制在 0.1eV 以下,意味着晶体管原有性能得以保持;漏极电流退化通常发生在晶体管受损时,表现为电流减弱。
在评估半导体老化速度的实验中,该技术也取得了较为稳定的结果。三星电子表示:“在高温、高电压应力实验(NBTI)中,ΔVt 仅为约 -8 mV,显示出良好特性,并确认器件可稳定工作 10 年以上。”同时,公司通过分子动力学(MD)和密度泛函理论(DFT)模拟进行分析,并解释称:“InGaO 晶体管的高热稳定性,源于沟道与电极界面处正负离子的外部扩散受到抑制。”
MD 模拟用于分析原子与分子随时间变化的运动状态,DFT 则用于计算材料内部电子的分布与结合情况。通过这两种方法,可以评估材料内部原子结合的稳定程度。InGaO 中的正负离子若在高温处理过程中发生外扩散,会改变晶体管的电学特性并导致性能下降。
业内人士指出,该项技术目前仍处于研究阶段,距离实际应用于三星电子的量产 DRAM 产品尚有一定时间,但未来有望应用于 10nm 以下的 0a 或 0b 世代 DRAM。
]article_adlist–>
<!-- 非定向300*250按钮 17/09 wenjing begin --> <!-- 非定向300*250按钮 end -->
</div>

