
焦平面阵列(FPA)因其高度的积分、鲁棒性和强大的动态适应性,在偏振成像领域引起了广泛关注。制造FPA的关键在于制造阵列各向异性亚波长光栅。传统技术如纳米印刻和基于掩膜的光刻依赖高精度模板,限制了灵活性,而电子束光刻等直接写入方法则难以满足大面积制造的效率要求。
最近,清华深圳国际研究生院李星辉副教授领导的研究团队在焦平面超像素阵列的光刻制造方面取得了新进展,为中红外偏振成像系统的关键部件制造提供了新颖解决方案。
针对中红外偏振成像应用,团队提出了单周期接触-干涉混合光刻技术。该方法使用不含细光栅条纹结构的窗罩,对干涉光刻产生的干涉条纹进行分割和修剪。采用四步曝光工艺,生成34微米×34微米超像素阵列的潜条纹图案,覆盖范围为20毫米×20毫米。每个超像素阵列包含四个不同方向和800纳米周期的光栅,图案通过显影、蚀刻和涂层的单一周期传输。
在这一技术路径上,为了减少掩膜与基板间隙对干涉条纹质量的影响,研究团队使用有限差分时域(FDTD)模拟分析间隙大小和间隙填充介质对干涉条纹的影响。选择甘油作为折射率匹配材料填补缝隙,并使用提拔阶段控制10微米以内的缝隙,显著抑制了对条纹质量的不良影响。
为解决分级曝光时叠加比对问题,团队基于显微成像技术开发了亚微米精度比对方案,并构建了专用比对观测平台。该方法在掩膜上使用双区域周期条纹标记,实现遮罩与基底之间的顶点对齐。
研究人员还制作了定制显微镜物镜,以精确观察掩膜上专门设计的周期线标记与光栅基底顶点图案之间的对齐。基于该系统,团队成功实现了分级光刻的亚微米叠加对准,有效避免了不同光栅区域之间的串扰。制造样品经过系统化的表面形态特征分析和光学性能测试。
扫描电子显微镜(SEM)用于表征样品表面的六个区域,这些区域均表现出良好的条纹质量和覆盖比对精度。采用傅里叶变换红外(FTIR)光谱仪测量光学透射率和偏振消光比。结果显示,在3μm–15μm中红外波段,TM偏振光的最大透射率达到50%,偏振消光比为20 dB。
所提的混合光刻技术在制造中等复杂度、多周期结构(如焦平面亚波长阵列)方面展现出显著优势,具备强大的工程应用潜力和重要的研究价值。这些成果以《单周期接触-干涉混合光刻法用于阵列象限微偏振结构可扩展制造》为题发表在顶级工程期刊《极限制造》上。
 图1:焦平面阵列的结构与工作原理
图1:焦平面阵列的结构与工作原理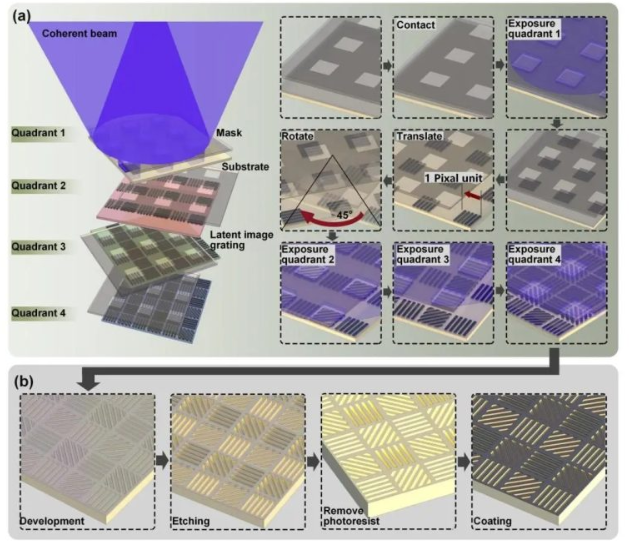 图2:混合光刻的制造工艺
图2:混合光刻的制造工艺 图3 |本研究提出的混合光刻系统:
图3 |本研究提出的混合光刻系统:(a)激光干涉光刻系统;
(b) 基底-遮罩姿态调整平台;
(c)波前分段干涉光刻系统及基板掩膜级;
(d) 具备对准能力的掩膜设计
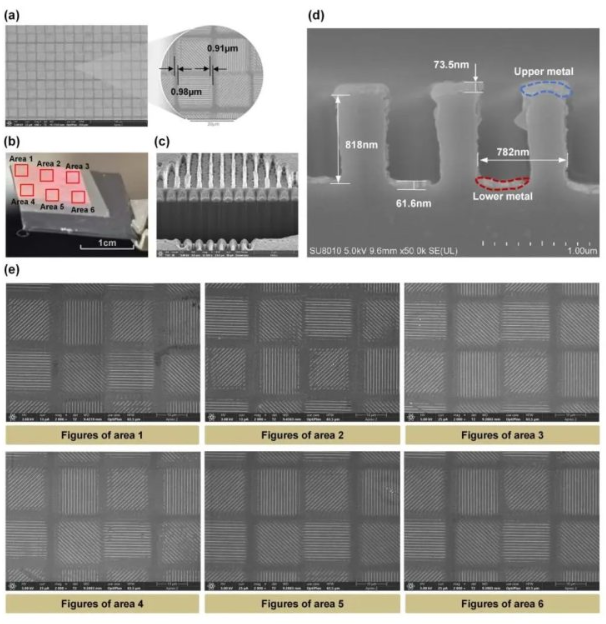
 图4:焦平面光栅阵列的表征与光学测试
图4:焦平面光栅阵列的表征与光学测试 <!-- 非定向300*250按钮 17/09 wenjing begin --> <!-- 非定向300*250按钮 end -->
</div>

